SiC substraatide töötlemise etapid on järgmised:
1. Kristallide suund:
Röntgendifraktsiooni kasutamine kristalli valuploki orienteerimiseks. Kui röntgenkiir on suunatud soovitud kristalli pinnale, määrab difraktsiooniga kiire nurk kristalli orientatsiooni.
2. Välisläbimõõduga lihvimine:
Grafiittiiglites kasvatatud üksikkristallid ületavad sageli standarddiameetrit. Välisläbimõõduga lihvimine vähendab neid standardsete suurusteni.
3. Otsapinna lihvimine:
4-tollistel 4H-SiC substraatidel on tavaliselt kaks positsioneerimisserva, esmane ja sekundaarne. Otsapinna lihvimine avab need positsioneerimisservad.
4. Traadi saagimine:
Traadi saagimine on 4H-SiC substraatide töötlemisel ülioluline samm. Traatsaagimisel tekkinud praod ja aluspinna kahjustused mõjutavad negatiivselt järgnevaid protsesse, pikendades töötlemisaega ja põhjustades materjalikadu. Levinuim meetod on teemantabrasiiviga mitme traadi saagimine. 4H-SiC valuploki lõikamiseks kasutatakse teemantabrasiivmaterjalidega ühendatud metalltraatide edasi-tagasi liikumist.
5. Lõikamine:
Et vältida servade lõhenemist ja vähendada kulukaod järgnevate protsesside käigus, faasitakse traatsaetud laastude teravad servad kindlaksmääratud kujuga.
6. Harvendamine:
Traadi saagimine jätab palju kriimustusi ja pinnaaluseid kahjustusi. Harvendamine toimub teemantrataste abil, et need defektid võimalikult palju eemaldada.
7. Lihvimine:
See protsess hõlmab töötlemata lihvimist ja peenlihvimist, kasutades väiksema suurusega boorkarbiidi või teemantabrasiive, et eemaldada hõrenemise käigus tekkinud jääkkahjustused ja uued kahjustused.
8. Poleerimine:
Viimased etapid hõlmavad töötlemata poleerimist ja peenpoleerimist, kasutades alumiiniumoksiidi või ränioksiidi abrasiive. Poleerimisvedelik pehmendab pinda, mis seejärel abrasiivide abil mehaaniliselt eemaldatakse. See samm tagab sileda ja kahjustamata pinna.
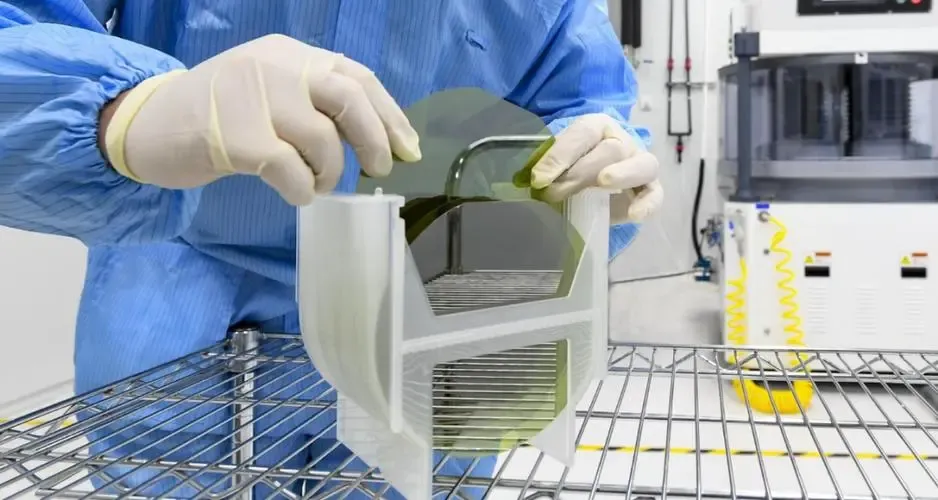
9. Puhastamine:
Osakeste, metallide, oksiidkilede, orgaaniliste jääkide ja muude töötlemisetappidest jäänud saasteainete eemaldamine.
Postitusaeg: mai-15-2024