Ränikarbiidi (SiC) epitaksia
Epitaksiaalalus, mis hoiab SiC substraati SiC epitaksiaalse viilu kasvatamiseks, asetatakse reaktsioonikambrisse ja puutub otse kokku vahvliga.

Ülemine poolkuu osa on Sic epitaksiseadmete reaktsioonikambri muude tarvikute kandja, samal ajal kui alumine poolkuu osa on ühendatud kvartstoruga, sisestades gaasi, mis sunnib sustseptori alust pöörlema. need on reguleeritava temperatuuriga ja paigaldatavad reaktsioonikambrisse ilma otsese kokkupuuteta vahvliga.

See on epitaksia

Alus, mis hoiab Si substraati Si epitaksiaalse viilu kasvatamiseks, asetatakse reaktsioonikambrisse ja puutub otse vahvliga kokku.

Eelsoojendusrõngas asub Si epitaksiaalse substraadialuse välisrõngal ning seda kasutatakse kalibreerimiseks ja soojendamiseks. See asetatakse reaktsioonikambrisse ega puutu otseselt vahvliga kokku.

Epitaksiaalne sustseptor, mis hoiab Si substraati Si epitaksiaalse viilu kasvatamiseks, asetatakse reaktsioonikambrisse ja puutub otse kokku vahvliga.

Epitaksiaalne tünn on põhikomponendid, mida kasutatakse erinevates pooljuhtide tootmisprotsessides, mida tavaliselt kasutatakse MOCVD-seadmetes, suurepärase termilise stabiilsuse, keemilise vastupidavuse ja kulumiskindlusega, mis sobib väga hästi kasutamiseks kõrge temperatuuriga protsessides. See puutub vahvlitega kokku.
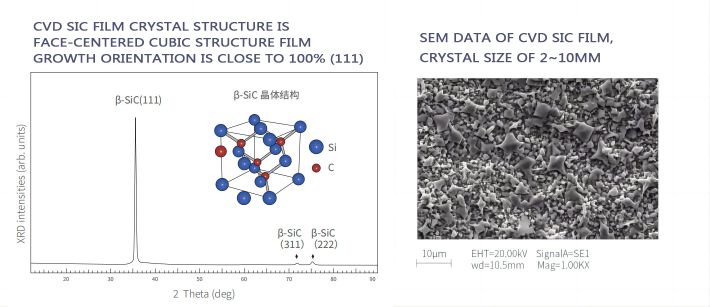
| Ümberkristalliseeritud ränikarbiidi füüsikalised omadused | |
| Kinnisvara | Tüüpiline väärtus |
| Töötemperatuur (°C) | 1600°C (hapnikuga), 1700°C (redutseeriv keskkond) |
| SiC sisu | > 99,96% |
| Tasuta Si sisu | <0,1% |
| Puistetihedus | 2,60-2,70 g/cm3 |
| Ilmne poorsus | < 16% |
| Survetugevus | > 600 MPa |
| Külm paindetugevus | 80–90 MPa (20 °C) |
| Kuum paindetugevus | 90–100 MPa (1400 °C) |
| Soojuspaisumine @1500°C | 4.70 10-6/°C |
| Soojusjuhtivus @1200°C | 23 W/m•K |
| Elastsusmoodul | 240 GPa |
| Soojuslöögikindlus | Ülimalt hea |
| Paagutatud ränikarbiidi füüsikalised omadused | |
| Kinnisvara | Tüüpiline väärtus |
| Keemiline koostis | SiC>95%, Si<5% |
| Puistetihedus | >3,07 g/cm³ |
| Ilmne poorsus | <0,1% |
| Rebenemismoodul temperatuuril 20 ℃ | 270 MPa |
| Rebenemismoodul temperatuuril 1200 ℃ | 290 MPa |
| Kõvadus temperatuuril 20 ℃ | 2400 kg/mm² |
| Murdetugevus 20% | 3,3 MPa · m1/2 |
| Soojusjuhtivus temperatuuril 1200 ℃ | 45 w/m .K |
| Soojuspaisumine temperatuuril 20-1200 ℃ | 4,5 1 × 10 -6/℃ |
| Max.töötemperatuur | 1400 ℃ |
| Soojuslöögikindlus temperatuuril 1200 ℃ | Hea |
| CVD SiC kilede füüsikalised põhiomadused | |
| Kinnisvara | Tüüpiline väärtus |
| Kristalli struktuur | FCC β faasi polükristalliline, peamiselt (111) orienteeritud |
| Tihedus | 3,21 g/cm³ |
| Kõvadus 2500 | (500g koormus) |
| Tera suurus | 2-10 μm |
| Keemiline puhtus | 99,99995% |
| Soojusvõimsus | 640 J·kg-1·K-1 |
| Sublimatsiooni temperatuur | 2700 ℃ |
| Paindetugevus | 415 MPa RT 4-punktiline |
| Youngi moodul | 430 Gpa 4pt painutus, 1300 ℃ |
| Soojusjuhtivus | 300W·m-1·K-1 |
| Soojuspaisumine (CTE) | 4,5 × 10-6 K -1 |
Peamised omadused
Pind on tihe ja poorideta.
Kõrge puhtusastmega, lisandite kogusisaldus <20ppm, hea õhutihedus.
Kõrge temperatuuritaluvus, tugevus suureneb kasutustemperatuuri tõustes, saavutades kõrgeima väärtuse temperatuuril 2750 ℃, sublimatsiooni temperatuuril 3600 ℃.
Madal elastsusmoodul, kõrge soojusjuhtivus, madal soojuspaisumistegur ja suurepärane soojuslöögikindlus.
Hea keemiline stabiilsus, vastupidav hapetele, leelistele, sooladele ja orgaanilistele reaktiividele ning ei mõjuta sulametalli, räbu ega muid söövitavaid aineid. See ei oksüdeeru märkimisväärselt atmosfääris temperatuuril alla 400 C ja oksüdatsioonikiirus suureneb oluliselt 800 ℃ juures.
Ilma kõrgel temperatuuril gaasi vabastamata suudab see hoida umbes 1800 °C juures vaakumit 10–7 mmHg.
Toote rakendus
Sulatustiigel pooljuhtidetööstuses aurustamiseks.
Suure võimsusega elektrooniline toruvärav.
Pintsel, mis puutub kokku pingeregulaatoriga.
Grafiitmonokromaator röntgenikiirguse ja neutronite jaoks.
Erineva kujuga grafiidist aluspinnad ja aatomabsorptsioonitoru kate.
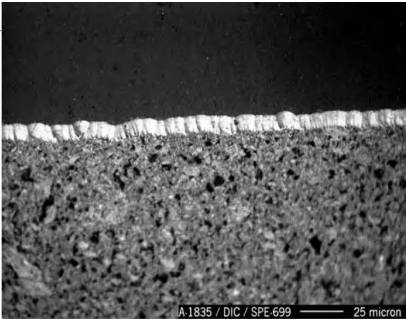
Pürolüütiline süsinikkatte efekt 500X mikroskoobi all, terve ja suletud pinnaga.
TaC kate on uue põlvkonna kõrge temperatuurikindel materjal, millel on parem kõrge temperatuuri stabiilsus kui SiC. Korrosioonikindla katte, oksüdatsioonivastase katte ja kulumiskindla kattena saab kasutada keskkonnas, mille temperatuur on üle 2000 ° C, kasutatakse laialdaselt kosmosetööstuse ülikõrge temperatuuriga kuuma otsa osades, kolmanda põlvkonna pooljuhtide monokristallide kasvuväljadel.



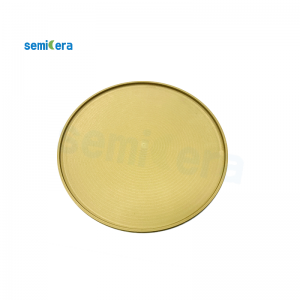
| TaC katte füüsikalised omadused | |
| Tihedus | 14,3 (g/cm3) |
| Eriemissioon | 0.3 |
| Soojuspaisumise koefitsient | 6,3 10/K |
| Kõvadus (HK) | 2000 HK |
| Vastupidavus | 1x10-5 oomi *cm |
| Termiline stabiilsus | <2500 ℃ |
| Grafiidi suurus muutub | -10-20 um |
| Katte paksus | ≥220um tüüpiline väärtus (35um±10um) |
Tahked CVD SILICON CARBIDE osad on tunnistatud esmaseks valikuks RTP/EPI rõngaste ja aluste ning plasmasöövitusõõnte osade jaoks, mis töötavad kõrgetel süsteemi nõutavatel töötemperatuuridel (> 1500°C), nõuded puhtusele on eriti kõrged (> 99,9995%). ja jõudlus on eriti hea, kui vastupidavus kemikaalidele on eriti kõrge. Need materjalid ei sisalda tera servas sekundaarseid faase, seega toodavad nende komponendid vähem osakesi kui teised materjalid. Lisaks saab neid komponente puhastada vähese lagunemisega kuuma HF/HCl-ga, mille tulemuseks on vähem osakesi ja pikem kasutusiga.